01
مقدمه
تاس ویفر بخش مهمی از تولید دستگاه های نیمه هادی است. روش تاس و کیفیت به طور مستقیم بر ضخامت، زبری، ابعاد و هزینه های تولید ویفر تأثیر می گذارد و تأثیر بسزایی در ساخت دستگاه دارد. کاربید سیلیکون، به عنوان یک ماده نیمه هادی نسل سوم، ماده مهمی است که انقلاب الکتریکی را پیش می برد. هزینه تولید{4}}کاربید سیلیکون کریستالی با کیفیت بالا بسیار بالا است و مردم معمولاً امیدوارند که یک شمش کاربید سیلیکون بزرگ را به تا آنجا که ممکن است برش دهند. در همان زمان، رشد صنعت منجر به اندازههای ویفر به تدریج بزرگتر شده است که الزامات فرآیندهای قطعهسازی را افزایش داده است. با این حال، کاربید سیلیکون بسیار سخت است، با سختی Mohs 9.5، پس از الماس (10)، و همچنین شکننده است و برش آن را دشوار می کند. در حال حاضر در روش های صنعتی عموماً از اره سیم دوغاب یا اره سیم الماسی استفاده می شود. در حین برش، اره های سیم ثابت با فواصل مساوی در اطراف شمش کاربید سیلیکون قرار می گیرند و شمش با استفاده از اره های سیم کشیده بریده می شود. با استفاده از روش اره سیمی، جداسازی ویفرها از یک شمش با قطر 6 اینچ تقریباً 100 ساعت طول می کشد. ویفرهای بهدستآمده دارای لبههای نسبتاً وسیع، سطوح ناهموارتر و تلفات مواد تا 46 درصد هستند. این امر هزینه استفاده از مواد کاربید سیلیکون را افزایش می دهد و توسعه آنها را در صنعت نیمه هادی محدود می کند و نیاز فوری به تحقیق در مورد فناوری های جدید برش ویفر کاربید سیلیکون را برجسته می کند.
در سالهای اخیر، استفاده از فناوری برش لیزری به طور فزایندهای در تولید مواد نیمهرسانا رایج شده است. این روش با استفاده از یک پرتو لیزر متمرکز برای اصلاح سطح یا داخل مواد و در نتیجه جداسازی آن کار می کند. به عنوان یک فرآیند غیر تماسی، از سایش ابزار و استرس مکانیکی جلوگیری می کند. بنابراین، زبری و دقت سطح ویفر را تا حد زیادی بهبود می بخشد، نیاز به فرآیندهای پرداخت بعدی را از بین می برد، تلفات مواد را کاهش می دهد، هزینه ها را کاهش می دهد و آلودگی محیطی ناشی از سنگ زنی و پرداخت سنتی را به حداقل می رساند. فناوری برش لیزری مدتهاست که برای برش شمش سیلیکون استفاده میشود، اما کاربرد آن در زمینه کاربید سیلیکون هنوز نابالغ است. در حال حاضر، چندین تکنیک اصلی وجود دارد.
02
برش لیزری هدایت شونده با آب
فناوری لیزر{0} هدایت شونده با آب (Laser MicroJet، LMJ)، همچنین به عنوان فناوری میکرو جت لیزری شناخته میشود، بر اساس اصل تمرکز پرتو لیزر بر روی نازل هنگام عبور از یک محفظه آب تعدیلشده با فشار عمل میکند. یک جت آب با فشار کم-از نازل خارج میشود و به دلیل تفاوت در ضریب شکست در رابط آب-، یک موجبر نوری تشکیل میشود که به لیزر اجازه میدهد در جهت جریان آب منتشر شود. این یک جت آب با فشار بالا-را برای پردازش و برش سطح مواد هدایت میکند. مزیت اصلی برش لیزر{9}} هدایت شونده با آب در کیفیت برش آن نهفته است. جریان آب نه تنها منطقه برش را خنک می کند، تغییر شکل حرارتی و آسیب حرارتی به مواد را کاهش می دهد، بلکه زباله های پردازش را نیز حذف می کند. در مقایسه با برش اره سیمی، به طور قابل توجهی سریعتر است. با این حال، از آنجایی که آب طول موج های لیزر مختلف را به درجات مختلف جذب می کند، طول موج لیزر در درجه اول به 1064 نانومتر، 532 نانومتر و 355 نانومتر محدود می شود.
در سال 1993، دانشمند سوئیسی Beruold Richerzhagen برای اولین بار این فناوری را پیشنهاد کرد. او Synova را تأسیس کرد، شرکتی که به تحقیق، توسعه و تجاری سازی فناوری لیزر هدایتشونده آب{2}} اختصاص دارد، که در سطح بینالمللی در خط مقدم است. فناوری داخلی نسبتاً عقب مانده است، اما شرکت هایی مانند Innolight و Shengguang Silicon Research به طور فعال در حال توسعه آن هستند.
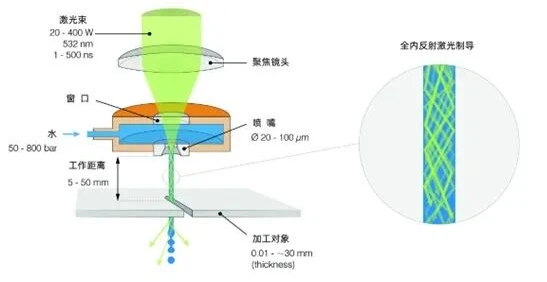
03
مخفی کاری
Dicing مخفی کاری (SD) تکنیکی است که در آن لیزر در داخل یک ویفر کاربید سیلیکون از طریق سطح آن متمرکز می شود تا یک لایه اصلاح شده در عمق مورد نظر تشکیل شود و جداسازی ویفر را امکان پذیر می کند. از آنجایی که هیچ برشی روی سطح ویفر وجود ندارد، می توان به دقت پردازش بالاتری دست یافت. فرآیند SD با لیزرهای پالس نانوثانیه قبلاً به صورت صنعتی برای جداسازی ویفرهای سیلیکونی استفاده شده است. با این حال، در طول پردازش SD کاربید سیلیکون القا شده توسط لیزرهای پالس نانوثانیه، مدت زمان پالس بسیار بیشتر از زمان جفت شدن بین الکترونها و فونونها در کاربید سیلیکون (در مقیاس پیکو ثانیه) است که منجر به اثرات حرارتی میشود. ورودی حرارتی زیاد روی ویفر نه تنها جداسازی را مستعد انحراف از جهت دلخواه میکند، بلکه باعث ایجاد تنش پسماند قابل توجهی میشود که منجر به شکستگی و شکاف ضعیف میشود. بنابراین، هنگام پردازش کاربید سیلیکون، فرآیند SD معمولاً از لیزرهای پالس فوق کوتاه استفاده می کند که اثرات حرارتی را تا حد زیادی کاهش می دهد.
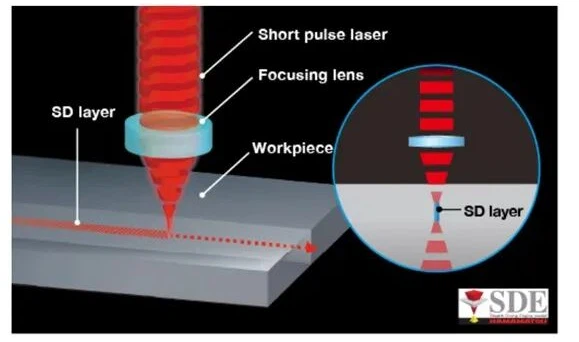
شرکت ژاپنی DISCO یک فناوری برش لیزری به نام Key Amorphous{0}}Black Repetitive Absorption (KABRA) توسعه داده است. برای مثال، در پردازش شمشهای کاربید سیلیکون به قطر 6{6}}اینچ و ضخامت 20 میلیمتر، بهرهوری ویفرهای کاربید سیلیکون را چهار برابر افزایش داد. فرآیند KABRA اساساً لیزر را در داخل ماده کاربید سیلیکون متمرکز می کند. از طریق "جذب تکراری آمورف سیاه"، کاربید سیلیکون به سیلیکون آمورف و کربن آمورف تجزیه می شود و لایه ای را تشکیل می دهد که به عنوان نقطه جداسازی ویفر عمل می کند که به عنوان لایه بی شکل سیاه شناخته می شود که نور بیشتری را جذب می کند و جداسازی ویفرها را بسیار آسان تر می کند.

فناوری ویفر Cold Split توسعه یافته توسط Siltectra، که توسط Infineon خریداری شده است، نه تنها می تواند انواع مختلف شمش ها را به ویفرها تقسیم کند، بلکه اتلاف مواد را تا 90 درصد کاهش می دهد و هر ویفر تا 80 میکرومتر از دست می دهد و در نهایت هزینه کل تولید دستگاه را تا 30 درصد کاهش می دهد. فن آوری Cold Split شامل دو مرحله است: اول، لیزر به شمش تابش می کند تا یک لایه لایه لایه ایجاد کند، که باعث انبساط حجم داخلی در ماده کاربید سیلیکون می شود، که تنش کششی ایجاد می کند و یک میکرو{4}}ترک بسیار باریک ایجاد می کند. سپس، یک مرحله خنک کننده پلیمری، ترک میکرو-را به ترک اصلی تبدیل میکند و در نهایت ویفر را از شمش باقیمانده جدا میکند. در سال 2019، یک شخص ثالث این فناوری را ارزیابی کرد و زبری سطح ویفرهای تقسیمشده را کمتر از 3 میکرومتر اندازهگیری کرد که بهترین نتایج کمتر از 2 میکرومتر بود.

تاس لیزری اصلاح شده که توسط شرکت چینی Han's Laser توسعه یافته است، یک فناوری لیزری است که برای جدا کردن ویفرهای نیمه هادی به تراشه ها یا قالب های جداگانه استفاده می شود. این فرآیند همچنین از یک پرتو لیزر دقیق برای اسکن و تشکیل یک لایه اصلاح شده در داخل ویفر استفاده میکند که به ویفر اجازه میدهد در طول مسیر اسکن لیزر تحت تنش وارده ترک بخورد و به جداسازی دقیقی دست یابد.
شکل 5. جریان فرآیند تاس لیزری اصلاح شده
در حال حاضر، تولیدکنندگان داخلی بر فناوری حصار بر اساس کاربید سیلیکون-تسلط دارند. با این حال، دیس دوغاب دارای تلفات مواد بالا، راندمان کم و آلودگی شدید است و به تدریج با تکنولوژی تار زنی سیم الماس جایگزین می شود. در عین حال، تاس لیزری به دلیل عملکرد و مزایای کارایی آن متمایز است. در مقایسه با فنآوریهای پردازش تماس مکانیکی سنتی، مزایای زیادی از جمله راندمان پردازش بالا، خطوط باریک نویس و چگالی بالا ارائه میکند که آن را به رقیبی قوی برای جایگزینی تارهای سیم الماس تبدیل میکند. مسیر جدیدی را برای استفاده از مواد نیمه هادی نسل بعدی مانند کاربید سیلیکون باز می کند. با پیشرفت فناوری صنعتی و افزایش مداوم اندازههای زیرلایه کاربید سیلیکون، فنآوری حفر کاربید سیلیکون به سرعت توسعه مییابد و تراش لیزری کارآمد-با کیفیت بالا روند مهمی برای برش کاربید سیلیکون در آینده خواهد بود.









